2018-05-16 国立研究開発法人 物質・材料研究機構
NIMSは、窒化ガリウム (GaN) 半導体の直径2インチウエハ結晶面の「ゆがみ」を、ウエハ全面を一度に、しかも数10マイクロメートルの空間分解能で可視化する新たな評価手法を開発しました。次世代パワーデバイスとして期待されるGaNのウエハ製造において、結晶欠陥の局所的な分布などを可視化し、結晶品質をすばやく詳細に評価できる技術として、今後の利用が期待されます。
概要
- 物質・材料研究機構 (以下、NIMS) は、窒化ガリウム (GaN) 半導体の直径2インチウエハ結晶面の「ゆがみ」を、ウエハ全面を一度に、しかも数10マイクロメートルの空間分解能で可視化する新たな評価手法を開発しました。次世代パワーデバイスとして期待されるGaNのウエハ製造において、結晶欠陥の局所的な分布などを可視化し、結晶品質をすばやく詳細に評価できる技術として、今後の利用が期待されます。
- GaNは、高耐圧性・省電力性などの特長により、電気自動車のモーターなどの駆動制御部品や、高速通信5G (第5世代移動通信システム) 向けの高周波デバイスへの応用が期待されています。そのデバイス性能は、GaN結晶の欠陥の数によって大きく左右されます。しかし、従来のX線回折を用いた結晶面の評価方法では、詳細に評価するためには、ビームサイズを小さくする必要があるため、ウエハ全面の測定に時間がかかる欠点がありました。また、ウエハ全面にX線を照射し、結晶面を一度に測定する方法では、結晶面の方向など詳細な情報は得られませんでした。
- 本研究チームは、ウエハ前面にX線を照射する手法を改良し、従来は1方向からのみのX線の回折強度を測定していた方法から、ウエハを回転させ2方向以上の回折強度を取得し、数学的に解析する手法を開発しました。この手法を用いることで、結晶面全面の「ゆがみ」の方向と大きさを、一度に定量的に可視化することに成功しました。実際に大型放射光施設(SPring-8)のシンクロトロンX線を用いて直径2インチのウエハを評価した結果、結晶面の形状を約30分で評価することができました。
- 本手法は、対象とする半導体の種類を限定しないため、GaN以外の様々な半導体ウエハの評価への応用が期待できます。
- 本研究は、NIMS技術開発・共用部門窒化ガリウム評価基盤領域放射光計測グループ・坂田修身グループリーダーらの研究チームによって、文部科学省「省エネルギー社会の実現に資する次世代半導体研究開発 (評価基盤領域) 」の一環として行われました。また、本研究成果は、特願2018-83268にて特許出願がなされました。
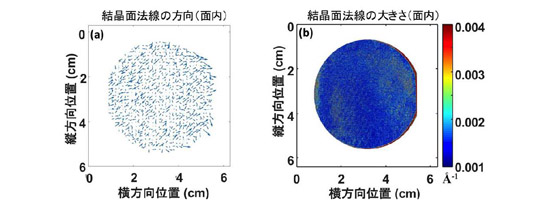
プレスリリース中の図1:(a) GaN半導体の2インチウエハの結晶面のゆがみの方向。(b) そのゆがみの大きさを濃淡で表示。



