2019-11-15 科学技術振興機構,大陽日酸株式会社,東京農工大学
ポイント
- 従来の手法はコストと結晶品質の面で、電子デバイスに要求される実用的なGaN結晶が製造できなかった。
- 三塩化ガリウム-アンモニア反応系により、高速、高品質、連続成長を実現するGaN結晶製造装置を開発した。
- 安価で高品質なバルク結晶の大量生産が可能となり、高性能GaNデバイス開発への突破口になると期待される。
JST(理事長 濵口 道成)は、産学共同実用化開発事業(NexTEP)の開発課題「THVPE法による高品質バルクGaN成長用装置」の開発結果を成功と認定しました。この開発課題は、東京農工大学 纐纈 明伯(コウキツ アキノリ) 特別招聘教授らの研究成果をもとに、平成25年8月から平成31年3月にかけて大陽日酸株式会社(代表取締役社長 市原 裕史郎)に委託して、同社開発本部、イノベーション事業本部にて実用化に向けて開発を進めていたものです。
窒化ガリウム(GaN)結晶は青色発光ダイオードとして広く利用されている半導体ですが、高速スイッチ動作や高耐圧大電流動作に関わるパワーデバイス材料としての特性も高く、現在の主流であるシリコン結晶に比べ非常に大きな優位性があります。
電子デバイス構造の土台となるGaN結晶基板の製造の多くはハイドライド気相成長法(HVPE法)注1)で製造されています。この手法は、結晶の反りなどの理由で厚みを確保することが難しく、種結晶である異種基板上に、1回に1ミリメートル未満のGaN結晶を成長させ、その都度はがして利用しています。そのため、炉の清掃など、結晶成長の前後処理にかかる工数などにより、コストと結晶品質の面で、実用的なGaN結晶が製造できませんでした。
大陽日酸はHVPE法を発展させ、三塩化ガリウム-アンモニア反応系を用いたトリハライド気相成長法(THVPE法)により、高速、高品質、連続成長を実現するGaN結晶製造装置を開発しました。これにより、結晶成長速度では従来の3倍、転位注2)欠陥においては従来の5分の1と、高品質な結晶を高速で形成することに成功しました。また反応炉である石英管の劣化が生じにくいこと、成長面積の減少注3)がないこと、不要なポリ結晶注4)成長が生じないことなど、従来法の高コストを引き下げるさまざまな特長も見いだされました。
この新技術により、GaN結晶を厚いバルクで得られれば、スライスしてGaN基板を大量生産できます。安価で高性能なGaNデバイスの開発への突破口になると期待されます。
産学共同実用化開発事業(NexTEP)は、大学などの研究成果に基づくシーズを用いた、民間企業が単独で事業化することが困難な、開発リスクが高く規模の大きい開発を支援し、実用化を後押しする事業です。
詳細情報 https://www.jst.go.jp/jitsuyoka/
<背景>
青紫色の発光ダイオードとして広く利用されている窒化ガリウム(GaN)結晶は、高速スイッチ動作や高耐圧大電流動作に関わる半導体材料としての特性が高く、現在のデバイスの主流であるシリコン結晶に比べ非常に大きな優位性があります。このため省エネルギーおよび低炭素社会構築のキーマテリアルとして注目されていますが、そのアプリケーションである高周波デバイス、パワーデバイスへの展開はあまり進んでいません。
その理由の1つに、GaN結晶基板の製造が難しい点があります。電子デバイス構造の土台となる結晶基板を製造するには、溶融引き上げ法でシリコン結晶を製造しているように高純度な厚いバルク結晶を得る結晶成長法が必要です。バルク結晶ができれば、スライスして基板を大量生産できます。
GaN結晶にはそのような手法がないため、従来はハイドライド気相成長法(HVPE法)が用いられています。この手法は、種結晶である異種基板の上に、1回に1ミリメートル以下のGaN結晶を成長させ、その後に異種基板をはがし、研磨してGaN基板を仕上げます。しかし、結晶周りに大量に付着するポリ結晶や、種結晶の欠陥などに起因する応力の蓄積によって引き起こされる結晶の反り、割れの発生などにより、それ以上の結晶成長は困難なため、コストや結晶品質の面で、実用的なGaN結晶が製造できていませんでした。
<開発内容>
大陽日酸は、高速、高品質、連続成長を実現するGaN結晶製造装置を開発しました。東京農工大学が特許を持つ技術をもとに、従来のHVPE法を発展させ、より高温(1200~1400度程度)で結晶を成長させる三塩化ガリウム-アンモニア反応系を用いたトリハライド気相成長法(THVPE法)(図1、2)による装置です。
開発したTHVPE装置は、石英反応管の耐熱温度1300度以上の高温環境(最大1600度)で直径4インチまでのGaN結晶が成長できる結晶成長炉(図3)を備えています。原料である液状の金属Gaを効率的に反応系に供給し確実に三塩化ガリウムにガス化する仕組み、さらに、原料ガスの流れを均一に保ち気相でGaNの核が生成するのを抑える仕組みを設けました。
また、種結晶としてGaN結晶のN極性面注5)を使用するため種結晶裏面(Ga極性面注5))の熱分解を防止するための保護膜を最適化しました。その結果、結晶成長速度は最大0.32ミリメートル毎時と従来法の3倍以上、転位欠陥は1×106毎立方センチメートル以下と従来法の5分の1の高品質の両立に成功しました(図4)。また、基板サイズにおいては直径2インチ(図5)、結晶厚みにおいては1.8ミリメートルまでの、透明な結晶成長ができることを確認しました。
さらに、石英管の劣化が生じないこと(図6)、成長面積の減少がないこと、結晶成長を中断させる不要なポリ結晶成長が生じないこと(図7)など、従来法の高コストを引き下げるさまざまな特長も見いだされました。
<期待される効果>
GaNは高性能デバイスへの適用が期待されるものの、GaN結晶のコスト、品質の面でデバイスへの展開が遅れています。THVPE法に基づき開発した手法は従来法と一線を画し、厚いバルクGaN結晶をスライスして基板を大量生産する新たな製造法を確立できる可能性があります。今後、GaN基板メーカーを中心に協業して、GaN結晶の厚膜化の実績を蓄積し、安価で高品質なGaNバルク結晶の大量生産が実現すれば、世界に先駆けた高性能GaNデバイス開発の突破口になると期待されます。
<参考図>
THVPE法(新技術)の反応
| ●GaCl2(三塩化ガリウム)生成反応 | ●GaN結晶成長反応 |
|---|---|
| ①Ga(l)+1/2Cl2(g)=GaCl(g)
②GaCl(g)+Cl2(g)=GaCl3(g) |
GaCl3(g)+NH3(g)=GaN(s)+3HCl(g) |
HVPE法(従来法)の反応
| ●GaCl(一塩化ガリウム)生成反応 | ●GaN結晶成長反応 |
|---|---|
| ①Ga(l)+HCl(g)=GaCl(g)+1/2H2(g) | GaCl(g)+NH3(g)=GaN(s)+HCl(g)+H2(g) |
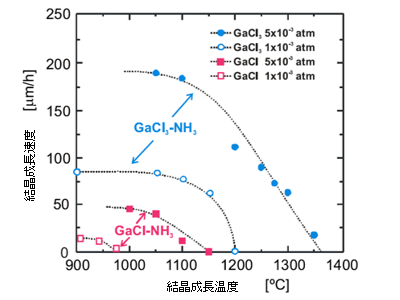
図2 THVPE法(新技術)とHVPE法(従来法)の成長速度比較
同じ気相濃度において、THVPE法の反応系(上部、青色)では、従来法の反応系(左下、赤色)より高速成長になる。本開発では条件を最適化し一層の高速化を果たした。
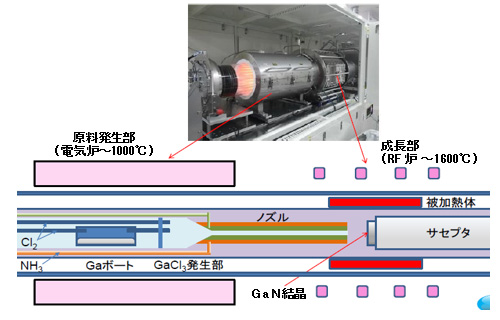
図3 結晶成長炉の外見と断面構造
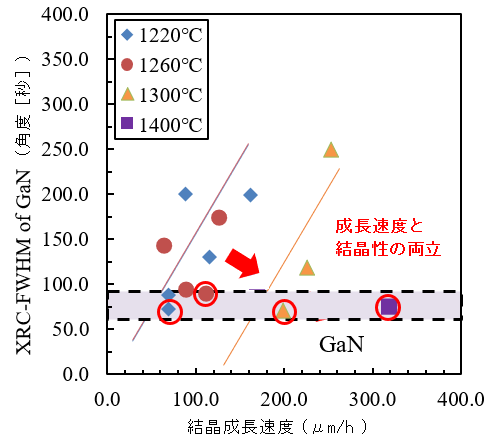
図4 GaN結晶成長における成長速度と結晶性
THVPE法(新技術)による結晶成長では、高い結晶成長速度(横軸)と高い結晶品質(縦軸)を両立した。同じ結晶品質では成長温度が高いほど結晶成長速度が大きい。縦軸のXRC-FWHM(X線ロッキングカーブの半値幅)は、小さいほど結晶面の向きが均一で結晶品質が高い。
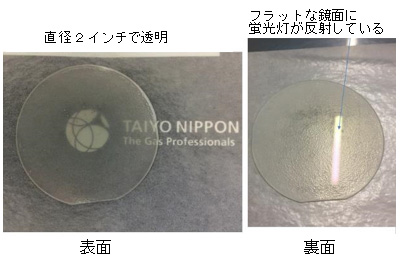
図5 直径2インチのGaN結晶例
直径2インチの透明な結晶が得られるとともに、種結晶裏面(Ga極性面)の熱分解を防止しフラットな鏡面のままであることが確認された。裏面に薄く金属Gaのすすが付いているが容易に拭き取れる。

図6 THVPE反応管
3年間の使用後、水洗いのみで透明度が回復し、石英管が劣化していないことを確認した。

図7 結晶成長後のサセプタ(結晶保持具)の様子
サセプタの「縁部分」の内側と、サセプタ内部にセットした背面版との間に種結晶となる薄いGaN結晶基板を挟んで固定し、露出した種結晶上にGaN結晶が成長する。結晶成長後、背面板やサセプタの周辺にポリ結晶の付着がほとんど見られないことから、結晶成長を阻害する不要なポリ結晶成長がほとんど生じないことが確認された。
<用語解説>
- 注1)ハイドライド気相成長法(HVPE法)
- 主に化合物半導体結晶の製造に用いられ、金属材料の塩化物ガスと非金属材料の水素化物ガスを基板上で反応させ、基板上に半導体結晶をエピタキシャル成長させる。エピタキシャル成長とは、基板の結晶配列を維持したまま成長させることで、基板の良し悪しが基板上に成長した結晶にも影響する。
実用化されている他の気相成長方法(MOCVD、MBEほか)に比べ、成長速度は速い方で(100マイクロメートル毎時)カーボン不純物が少ないというメリットがあるが、複数の結晶を順番に成長させる際の結晶と結晶の界面が平坦になりにくいというデメリットもある。そこで工業的には、種基板上にGaN結晶をある程度厚く成長させた後、種基板をはがし、できた結晶を基板として仕上げる、GaN基板製造装置としての需要がある。
- 注2)転位
- 結晶中に存在する線状の欠陥であり、結晶のずれ方により、刃状転位、らせん転位、混合転位などがある。GaNなどの六方晶型の結晶の場合、結晶成長方向に貫通するものを貫通転位という。基板にこのような転位欠陥が存在すると、HVPEなどでエピタキシャル成長した結晶、ひいてはそれを用いて製作したデバイス部品の性能を劣化させる。
- 注3)成長面積の減少
- 一般に結晶の面方位によって、性質や成長速度が異なる。GaN結晶においては、通常のHVPE法で使用するGa極性面上に成長していくと、成長速度の優る斜め方向の特定の面が外周側から現れ、厚みを増すとその面が増長され、結果として結晶は砲台の形状のように、上側ほど面積が減少する。一方、その反対の面であるN極性面に成長させるTHVPE法では、逆の状況となり、厚さが増しても成長面(上面)の減少は見られない。
- 注4)ポリ結晶
- 多数の微小な単結晶からなる結晶体。ポリクリスタル、多結晶、雑晶ともいう。
- 注5)N極性面、Ga極性面
- GaN結晶のような化合物半導体の六方晶構造では、単位ユニットである六角柱の上下端面の性質が異なる。この端面のうち、Ga原子が表面に出ている方の面(Ga(極性)面、+C面などと記述される)は、通常HVPE法などの気相成長法により使用される面であり、他方の面(N(極性)面、-C面などと記述される)に比べ低温から熱分解しやすい性質がある。しかし気相成長ではこの面に結晶のもととなる原料ガスを大量に届け、化学反応にて結晶を成長させるため、実質的に熱分解を防いでいる。
THVPE法では、HVPE法で使用するGa極性面には結晶がほとんど成長せず、反対のN極性面でよく成長することが知られている。これはTHVPE法の原料である三塩化ガリウムに起因する。このためTHVPE法の成長では、通常の基板をひっくり返してN極性面上に原料ガスを当て、結晶成長させる。
<お問い合わせ先>
<開発内容に関すること>
山口 晃(ヤマグチ アキラ)
大陽日酸株式会社 開発本部 つくば研究所
<JST事業に関すること>
沖代 美保(オキシロ ミホ)
科学技術振興機構 産学共同開発部
<報道担当>
科学技術振興機構 広報課
大陽日酸株式会社 管理本部 広報・IR部(鎌田)
東京農工大学 企画課 広報係