2018/09/04 国立研究開発法人 産業技術総合研究所
ポイント
- 長さの国家標準にトレーサブルなレーザー光源と2台の光干渉計を用いて試料の厚さを測定
- シリコンウエハー内部の屈折率に影響されずに厚さを測定可能
- シリコンウエハーの高精度品質管理に貢献し、半導体性能の向上に期待
概要
国立研究開発法人 産業技術総合研究所【理事長 中鉢 良治】(以下「産総研」という)工学計測標準研究部門【研究部門長 高辻 利之】ナノスケール標準研究グループ 平井 亜紀子 研究グループ長と長さ標準研究グループ 尾藤 洋一 研究グループ長は、長さの国家標準にトレーサブルに試料厚さを測定できる厚さ測定用両面干渉計を開発し、シリコンウエハーの厚さ測定に応用した。
半導体製造では、業界団体がシリコンウエハーの寸法の規格を定めており、厚さは重要な項目の一つである。近年、測定結果の信頼性が一層重要になっており、シリコンウエハーの厚さ測定でも国家標準へのトレーサビリティへの要求が高まっている。また、集積度向上のための三次元積層用のシリコンウエハーではこれまで以上の薄さが求められ、厚さ管理は一層重要となっている。
厚さの非接触測定には、分光干渉方式が広く用いられているが、試料内部の屈折率に影響されるため測定結果の信頼性が保証できなかった。今回開発した技術では、可視光を用い表面反射光だけを使用して、2台の光干渉計で試料両側の表面形状を測定し、それらを組み合わせて試料の幾何学的厚さを直接求める。試料内部を透過した光は使用しないので、試料の屈折率に影響されない。また、長さの国家標準にトレーサブルな複数台の周波数安定化レーザーを可視光の光源として用いるため、厚さの測定結果も国家標準にトレーサブルとなる。本技術により厚さが測定された標準試料を用いて製造現場で既に使われている測定装置を校正すれば、計測結果の信頼性が向上する。
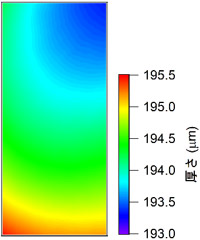
今回開発した技術で測定した200 µm厚シリコンウエハーの厚さ分布の例(約30 mm×10 mmの領域)
開発の社会的背景
近年、半導体製造では、素子の高密度化が一層求められている。そのため、微細化の他に、シリコン貫通電極を用いた三次元積層デバイスにより集積度を向上させる技術が注目されている。デバイスを積層させるために、従来よりも薄いシリコンウエハーが用いられるので、ウエハーの厚さ管理は一層重要となっている。
非接触の厚さ測定には、シリコンを透過する赤外光を用いて、試料表面からの反射光と試料内部を透過した試料裏面からの反射光の干渉を利用する分光干渉方式が広く用いられている。しかし、測定結果は試料の屈折率と幾何学的厚さの積である光学的厚さとなるため、必要な幾何学的厚さを求めるためには屈折率の正確な情報が必要となる。一般にシリコンの屈折率の文献値が使用されているが、メーカーや装置によって異なる文献値が使用され、業界で統一した値がない。また、屈折率はロット毎のばらつきがあり、さらに、シリコンに添加する微量の不純物の濃度によっても屈折率が変わるため、用いた文献値が正しいとは限らず、測定された幾何学的厚さの信頼性が保証できなかった。そのため、現場の測定装置をその場で校正できる標準試料が求められていた。
研究の経緯
産総研では、これまで、光の干渉を利用した長さの精密測定技術を開発し、国家計量標準として供給している。今回、これらの精密測定技術を活用し、試料の厚さを高精度で測定できる装置の開発に取り組んだ。
研究の内容
今回開発した厚さ測定用両面干渉計は、2台のレーザー干渉計から構成されている(図1)。被測定試料の両側にレーザー干渉計を配置し、試料の右面と左面のそれぞれについて、試料表面で反射した光と参照鏡で反射した光との干渉縞画像をCCDカメラで計測して、試料の両面それぞれの凹凸形状を測定する。複数枚の干渉縞画像を測定することで、計算によって試料表面の凹凸形状を高精度に求められる。同時に、試料の周囲の何もない空間を透過した光と参照鏡で反射した光との干渉縞画像も計測し、厚さ測定の基準平面も求める。これらの結果を組み合わせて、試料の厚さ分布を求める。光の干渉縞は、干渉計の光路差に対して、光源からの光の波長を1周期とした周期関数なので、凹凸形状のように相対的な長さは正確に測定できるが、絶対的な長さを求めることが困難である。しかし、本装置では、周波数(波長)の異なる3種類の周波数安定化レーザーを光源として用いている。そのため、波長ごとに測定を行い合致法によって絶対的な長さを求めることができる。
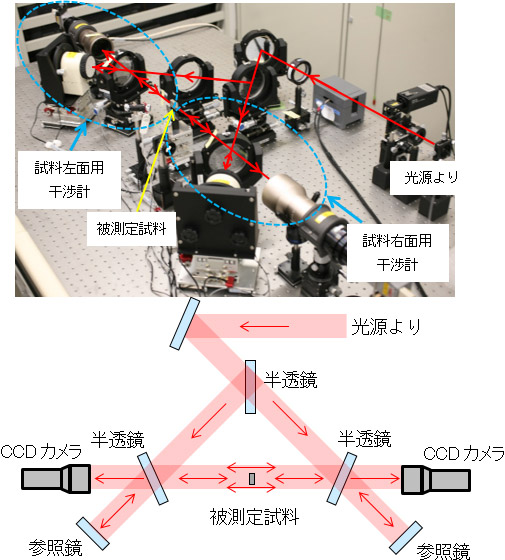
図1 今回開発した厚さ測定用両面干渉計
新しく開発した厚さ測定用両面干渉計で、代表的な実用長さ標準器の一つであるブロックゲージの厚さを測定し、測定結果の妥当性を検証した。厚さ1 mmから30 mmの校正済みブロックゲージを両面干渉計で測定したところ、厚さの測定結果はブロックゲージの校正値と±10 nm以内で一致することが確認できた。
次に大塚電子株式会社シリコンウエハーの厚さを測定した。約30 mm×10 mmに切り出されたシリコンウエハー片の測定面が鉛直になるように設置する。図2に、測定した厚さ約200 µmのシリコンウエハーと保持具の外観、シリコンウエハーの両側の干渉縞画像と、それらから計算されたウエハー両面の高さ分布(凹凸形状)、両者を合成して最終的に得られた厚さ分布の例を示す。こうして校正されたシリコンウエハーは、ウエハー製造メーカーなどが保有する厚さ測定装置の校正用標準試料として使用できる。シリコンウエハーの品質向上につながり、半導体性能の向上への貢献が期待される。

シリコンウエハー保持具
シリコンウエハーと保持具は大塚電子株式会社提供
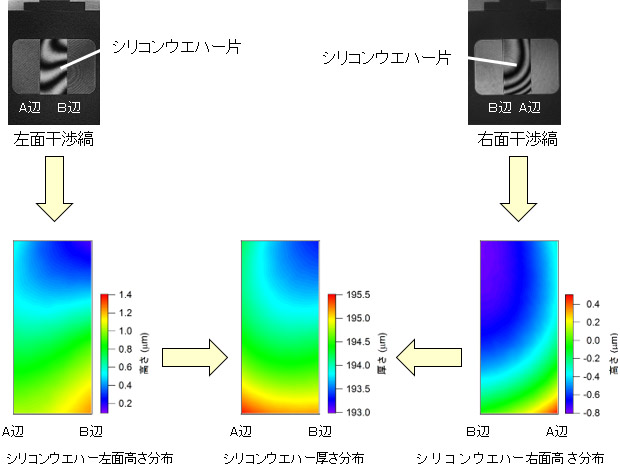
図2 シリコンウエハーの厚さ測定結果
今後の予定
今後は、積層用のより薄いシリコンウエハーへの対応など、測定できる厚さの範囲を拡大する。また、ウエハー内部の影響を受けずに幾何学的厚さが求められるので、分光干渉方式の結果と比較して、分光干渉方式で使われているシリコンの屈折率の検証、屈折率の不純物濃度依存性の評価、ウエハー内部の屈折率均一性評価を行う。さらに、LEDや面発光レーザー用に市場が拡大しているGaAsウエハーや、光集積回路や超高速電子デバイスの基本材料であるInPウエハーなど、さまざまウエハーの厚さ測定に応用して、半導体素子の品質管理や性能向上に貢献していく。
用語の説明
- ◆国家標準にトレーサブル
- ある測定装置が標準器によって校正され、その標準器もより正確な(不確かさがより小さい)標準器によって校正されている、といった測定器の校正の連鎖が国家標準にたどり着けることが確かめられている場合、この測定装置により得られた結果は国家標準にトレーサブルであるという。
- ◆分光干渉方式
- 膜厚や板厚を測定する方法の一つ。試料に広帯域光(広い波長範囲の光)を照射して、試料表面からの反射光と試料内部を透過した試料裏面からの反射光を干渉させる。二つの光の間の光路差(試料厚さの2倍)が光源の光の波長の1/2の偶数倍のとき強めあい、1/2の奇数倍のとき弱めあう干渉となる。干渉した光を分光器で分光すると、強め合う波長、弱め合う波長がわかるので、それらから光路差、すなわち試料厚さを求める方式。
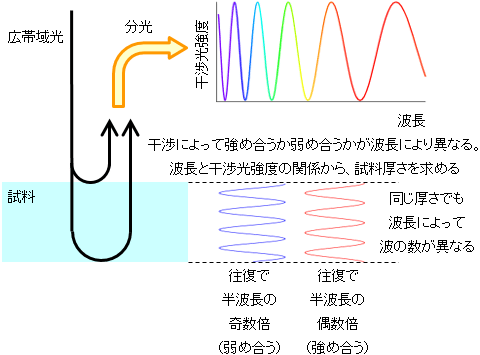
- ◆幾何学的厚さ、光学的厚さ
- 幾何学的厚さは、板や膜などの実際の厚さ。板や膜の屈折率がnのときは、この中を透過する光が感じる厚さはn倍され、これを光学的厚さと呼ぶ。同じ幾何学的厚さであっても、屈折率が異なる場合は、光学的厚さは異なる。
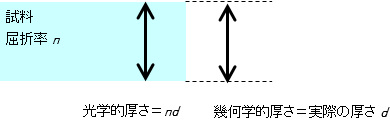
- ◆干渉縞画像
- 試料の表面形状を干渉計で観測した場合、干渉光は表面の高さに依存した明るさで観測される。画像として観測すると、光源の光の波長の1/2間隔(往復で一波長)の等高線のような縞画像が得られる。これを干渉縞画像と呼ぶ。
- ◆光路差
- 干渉計では、同一の光源から出た光が半透鏡などにより二つ以上に分かれ、それぞれが異なる光路を通った後再び重ね合わさって干渉する。それぞれの光路の長さの差を光路差と呼ぶ。
- ◆合致法
- 一つの光源で長さを干渉測定する場合、干渉縞の周期性のために干渉縞の整数次数は直接わからない。複数の異なる波長の光で同じ長さを干渉測定すれば、全ての波長に対してつじつまが合う整数次数を求めることができ、絶対長さが得られる方法。ブロックゲージの校正にも使用されている。