2020-12-06 東京大学
○添付資料:
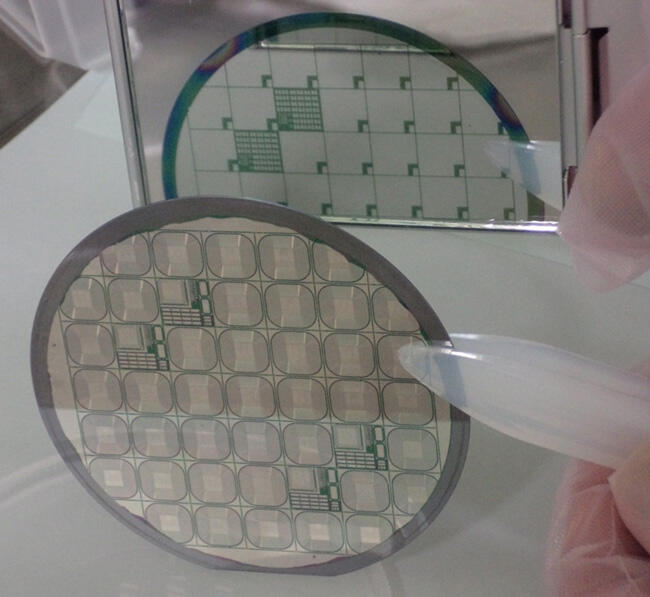
シリコンウェハに試作された両面ゲートIGBTチップ。後ろの鏡には、裏面のパターンが確認できる。
○発表者:
更屋 拓哉(東京大学 生産技術研究所 助手)
平本 俊郎(東京大学 生産技術研究所 教授)
○発表のポイント:
◆シリコンIGBTはパワートランジスタの一種で、家電製品や自動車、鉄道、産業機器等に広く用いられています。電力変換効率をより向上させるため、電流密度が大きく損失の小さなパワートランジスタが強く求められています。
◆本研究では、IGBTのMOSゲート部を従来のシリコン基板の表面のみではなく、基板の裏面にも設けた「両面ゲートIGBT」を両面リソグラフィ技術を用いて世界で初めて試作し、従来のIGBTと比較してスイッチング損失が62%低減することを実証しました。
◆シリコンIGBTの更なる進化の可能性を示す成果であり、パワーエレクトロニクスの効率改善、ひいては増大を続ける電力需要の抑制に貢献することが期待されます。
○発表内容:
東京大学 生産技術研究所の更屋 拓哉 助手、平本 俊郎 教授らの研究グループは、シリコン絶縁ゲートバイポーラトランジスタ(IGBT)の表裏両面にMOSゲートを設ける両面ゲートIGBTを作製し、6割を超えるスイッチング損失の低減を実証することに成功しました。
半導体パワートランジスタは、パワーエレクトロニクスにおけるキーデバイスであり、電力変換に用いられるスイッチングトランジスタです。パワートランジスタとしては、シリコンを材料とするパワーMOSトランジスタ(注1)や絶縁ゲートバイポーラトランジスタ(Insulated Gate Bipolar Transistor、IGBT)(注2)が広く普及しています。特にIGBTは、高い耐圧、MOSゲート(注3)による高速性、および伝導度変調(注4)による大電流特性から家電製品や自動車、鉄道、産業機器などに広く用いられており、最も重要なパワートランジスタの一つです。ところが、一般にシリコンIGBTは性能限界に近づいているとされています。パワーエレクトロニクスにおける電力変換効率をより向上させるため、電流密度が大きく損失の小さなパワーデバイスが強く求められており、シリコンに代わる材料としてシリコンカーバイドSiCや窒化ガリウムGaN(注5)などを用いたトランジスタが活発に研究されています。
一方、現在主流のパワートランジスタであるシリコンIGBTの性能をさらに向上させることができれば、パワーエレクトロニクスに大きな波及効果をもたらします。本研究グループでは、シリコンを材料とするシリコンIGBTの性能向上に一貫して取り組んでいます。
IGBTでは、集積回路を構成するMOSトランジスタとは異なり、電流は基板の上下方向に流れます。IGBTでは大電流をオン・オフ(スイッチング)させるために、MOSトランジスタのゲート部に相当するスイッチング機構がシリコン基板の上部に設けられています。このゲートに信号を入力することで、大電流のスイッチングを行います。ところが、IGBT特有の現象として、IGBTをオフにする際、基板内部にたまった電子と正孔を排出するのに時間がかかるため、中途半端にオフの状態で電流が流れ続け、電力を消費してしまう(損失が発生してしまう)という欠点がありました。基板の裏面にもMOSトランジスタのゲート部を設ければ、裏面からの正孔注入遮断および電子の排出を効果的に行うことができ、スイッチング損失が低減することは1990年代から提案されていましたが、シミュレーションのみによる研究であり、製造可能なプロセスによる両面ゲートIGBT試作とスイッチング損失低減実証は行われていませんでした。
今回、東京大学の研究グループは、三菱電機株式会社、東芝デバイス&ストレージ株式会社、東京工業大学、明治大学、九州大学、九州工業大学と共同で、基板の裏面にもMOSゲート部を有する両面ゲートIGBTを両面リソグラフィプロセスを用いて試作することに成功し、従来構造と比較して62%のスイッチング損失低減を実証することに成功しました。
シリコン基板の裏面にMOSトランジスタのゲート部を作りこむため、大学のクリーンルームにおいて基板の両面にリソグラフィを行うことのできる環境を整えました。3300V級の両面ゲートIGBTを設計し、試作したところ、裏面のMOSトランジスタも正常に動作することが確認できました。両面ゲートIGBTとして動作させたところ、表のゲートと裏のゲートに入力するタイミングを調整することにより、表のみにMOSゲート部を有する従来IGBTと比較して、62%のスイッチング損失低減の実証に成功しました。
本研究グループでは、2019年5月にIGBTのスケーリング技術により5Vのゲート駆動電圧で3300V級IGBTのスイッチングに成功し、電流密度の向上とスイッチング損失低減を実証しました。今回の成果も、材料を変えずにデバイス構造を変えるだけで、現在主流のパワートランジスタであるシリコンIGBTが今後も性能向上が可能であることを示しています。パワーエレクトロニクスの電力変換効率の向上に寄与することから、増大する電力需要の抑制に貢献することが期待できます。また、両面ゲートIGBTの損失低減効果は耐圧が高いほど大きいことから、本研究は、シリコンではこれまで困難と考えられていたより高耐圧のパワートランジスタの領域(10,000V以上)へシリコンの可能性を拓く成果と言えます。
本成果を、12月12-18日にオンラインで開催されるIEEE International Electron Devices Meeting(IEDM)にて発表します。
本研究は、(国研)新エネルギー・産業技術総合開発機構(NEDO)「低炭素社会を実現する次世代パワーエレクトロニクスプロジェクト」の「新世代Siパワーデバイス技術開発」(JPNP10022)の一環で行われました。また、本研究は、プロジェクト企画起案元である(一社)NPERC-Jの産学メンバーの極めて緊密な連携のもとで実施されました。
○発表会議:
国際会議名:IEEE International Electron Devices Meeting (IEDM)
会期:2020年12月12-18日(ただし講演ビデオは米国太平洋時間12月7日、論文は米国太平洋時間12月5日に公表)
開催場所:オンラインコンファレンス
論文タイトル:3.3 kV Back-Gate-Controlled IGBT (BC-IGBT) Using Manufacturable Double-Side Process Technology
著者:T. Saraya1, K. Itou1, T. Takakura1, M. Fukui1, S. Suzuki1, K. Takeuchi1, M. Tsukuda7, K. Satoh2, T. Matsudai3, K. Kakushima4, T. Hoshii4, K. Tsutsui4, H. Iwai4, A. Ogura5, W. Saito6, S. Nishizawa6, I. Omura7, H. Ohashi4, and T. Hiramoto1
1 The University of Tokyo, Tokyo, Japan, 2 Mitsubishi Electric Corp., Fukuoka, Japan, 3 Toshiba Electronic Devices & Storage Corp., Tokyo, Japan, 4 Tokyo Inst. of Technology, Yokohama, Japan, 5 Meiji University, Kawasaki, Japan, 6 Kyushu University, Kasuga, Japan, 7 Kyushu Inst. of Technology, Kitakyushu, Japan
○問い合わせ先:
東京大学 生産技術研究所
教授 平本 俊郎(ひらもと としろう)
○用語解説:
(注1)パワーMOSトランジスタ
大電力を扱う金属-酸化膜-半導体(MOS)電界効果トランジスタのこと。通常はnチャネルであり、伝導に寄与するキャリアは電子のみである。キャリアが1種類であるので、いわゆるユニポーラデバイスである。MOS構造を有するゲート部に入力電圧を加えると、電界により半導体に電子が誘起され導通状態(オン状態)となる。入力電圧をオン・オフすることで、大電流の導通をオン・オフすることができ、高速なスイッチング特性を有する。100V程度以下の耐圧でよく用いられるが、耐圧を高くしようとするとオン抵抗が増大してしまうという欠点がある。
(注2)IGBT
絶縁ゲートバイポーラトランジスタ(Insulated Gate Bipolar Transistor)の略。入力部はMOS構造、出力部はバイポーラ構造を有する。高い耐圧を得るため非常に長いベース領域(数十~数百μm)をもつが、電子と正孔双方のキャリアをベース領域に注入・蓄積することで後述の伝導度変調が起こり、高い耐圧と高電流の導通を両立できる特徴をもつ。またMOSゲート部によりキャリアの注入を制御するため比較的高速なスイッチング特性を有する。
(注3)MOSゲート部
MOSトランジスタの入力部で、金属-酸化膜-半導体構造を有する。IGBTでも入力部にMOSゲート部が用いられている。
(注4)伝導度変調
パワーMOSトランジスタはユニポーラデバイスであるのに対し、IGBTは負の電荷をもつ電子と正の電荷をもつ正孔が伝導に寄与するバイポーラデバイスである。IGBTではオン時に基板表面から電子が、基板裏面から正孔がそれぞれ注入され、正負の電荷が打ち消しあうことによって非常に多くのキャリアをため込むことができるので、抵抗を非常に低くすることができる。これを伝導度変調と呼ぶ。IGBTは電導度変調により高電流の導通が可能となっている。
(注5)シリコンカーバイドSiC、窒化ガリウムGaN
禁制帯幅(バンドギャップ)がシリコンより大きく、高い電界に耐えられる性質をもっているため、高耐圧用途に適した材料である。シリコンに代わるパワーデバイス向け材料として盛んに研究開発が行われおり、一部製品化されている。


